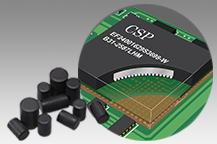
- モールドアンダーフィル(MUF)材により、フリップチップ下の狭ギャップ充填と全体封止をボイドレスで一括成形
- 独自のファインフィラー高充填設計技術・樹脂設計技術により、最適な熱収縮を実現し、
パッケージの低反り化に貢献
半導体封止材
- 品 番

CV8581 CV8713
- 用 途
- 詳細用途


・半導体パッケージ
・モバイル
・モバイル
最先端半導体パッケージ(FC-CSP、FC-SiPモジュールなどのフリップチップパッケージ)
プレスリリース
- 2018-02-08中国・上海でモールドアンダーフィル対応半導体封止材の生産を開始
特長
工程時間短縮
狭ギャップ/ピッチ充填
低反り
EMC (Epoxy Molding Compound) 説明動画
プロセス比較
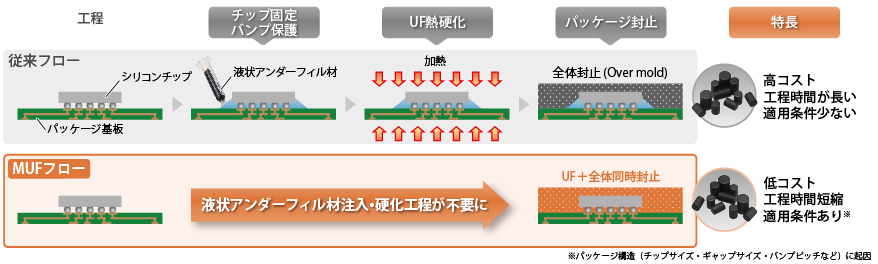
狭ギャップ・狭ピッチ充填対応可能
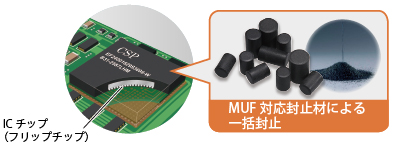
対応パッケージ例
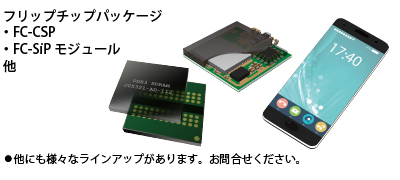
一般特性
| 項目 | 単位 | LEXCM CF | |||
| CV8581MUW | CV8713UB | CV8714AHSL | X8770UY | ||
| Tg (TMA) | °C | 170 | 145 | 153 | 150 |
| CTE 1 | ppm/°C | 20 | 9 | 12 | 9 |
| CTE 2 | 64 | 38 | 47 | 40 | |
| 曲げ弾性率 (25°C) | GPa | 16 | 24 | 23 | 26 |
| フィラーサイズ (最大) | µm | 20 | 20 | 10 | 20 |
| 成形収縮率 | % | 0.32 | 0.20 | 0.21 | 0.20 |
上記データは当社測定による代表値であり、保証値ではありません。