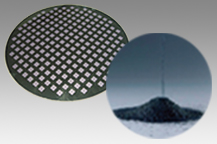
- 封止厚みと一括封止サイズに応じて、顆粒のラインアップを保有し、圧縮成形に対応可能。
- 薄型パッケージの大判化・低反りに対応し、先端半導体パッケージの生産性向上に貢献。
半導体封止材
- 品 番

CV8511CUB (EMC)
- 用 途
- 詳細用途


・半導体パッケージ
・モバイル
・モバイル
先端モバイル・ウエアラブルデバイス用先端半導体パッケージなどのWLP、PLPのオーバーモールド、ウエハバックコートなど
トピックス
- 2018-08-29パナソニックがFOWLP/PLP対応の顆粒状半導体封止材を製品化
特長
低応力
低収縮率
低温硬化
FOWLPの技術動向
低反りと薄型化に貢献

ラインアップと対応パッケージ
WLP/PLP向けに幅広いラインアップを取り揃えています。
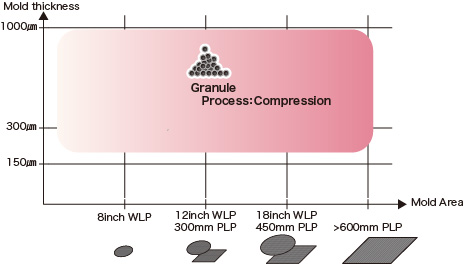
封止プロセス
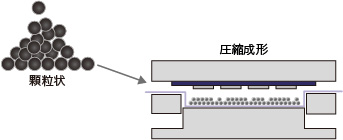
一般特性
| 項目 | 単位 | LEXCM CF CV8511CUB |
LEXCM CF X85U-PT1-AP |
| モールドサイズ | - |
ウエハサイズ/パネルサイズ
|
|
| 成形手法 | – |
圧縮成形 |
|
| 対応工法 | – |
Chip First / Chip Last |
|
| 供給形態 | – |
顆粒状
|
|
| 成形収縮率 | % | 0.15 | 0.07 |
| Tg | °C | 210 | 174 |
| C.T.E.1 | ppm/°C | 8 | 7 |
| C.T.E.2 | ppm/°C | 56 | 25 |
| 曲げ弾性率 (25°C) | GPa | 8 | 30 |
上記データは当社測定による代表値であり、保証値ではありません。

