
- 半導体パッケージの薄型化(絶縁層厚み15μm以下)を実現する極薄サブストレート材料
- 熱膨張率の差によって発生する反りを抑制することで優れた実装信頼性を実現します。
電子回路基板材料
- 品 番
低熱膨張ガラスクロス
Laminate R-G515S
Prepreg R-G510S
一般ガラスクロス
Laminate R-G515E
Prepreg R-G510E

- 用 途
- 詳細用途

・半導体パッケージ
半導体パッケージ基板
CSP (PoP-Bottom、Flip-Chip、Memory、Moduleなど)
CSP (PoP-Bottom、Flip-Chip、Memory、Moduleなど)
主要特性
CTE x,y-axis 4-6ppm/°C
(低熱膨張ガラスクロス)
(低熱膨張ガラスクロス)
低反り
極薄材料
成型性に優れる
成型性に優れる
パッケージ基板反り評価結果
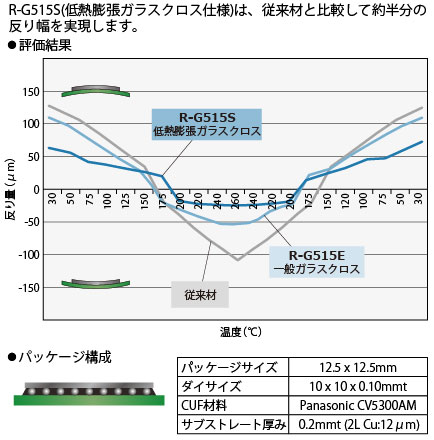
溶融粘度挙動
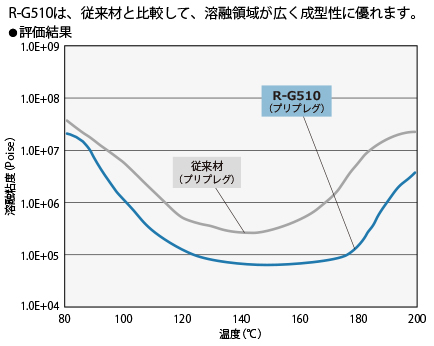
一般特性
| 項目 | 試験方法 | 条件 | 単位 | LEXCM GX R-G515S 低熱膨張ガラスクロス | LEXCM GX R-G515E 一般ガラスクロス | |
| ガラス転移温度(Tg) | DMA※² | A | °C | 220-240 | 220-240 | |
| 熱膨張係数(タテ方向) | α1 | 社内法 | A | ppm/°C | 4-6 | 6-8 |
| 熱膨張係数(ヨコ方向) | 4-6 | 6-8 | ||||
| 比誘電率(Dk)※¹ | 1GHz | IPC-TM-650 2.5.5.9 | C-24/23/50 | - | 4.2 | 4.4 |
| 誘電正接(Df)※¹ | 0.008 | 0.008 | ||||
| 曲げ弾性率※¹ | JIS C 6481 | 25°C | GPa | 28 | 24 | |
試験片の厚さは0.1mmです。
※1 0.8mm ※2 引張りモードでの測定
当社のハロゲンフリー材料は、JPCA-ES-01-2003などの定義に拠るものです。
含有率が塩素(Cl):0.09wt%(900ppm)以下、臭素(Br):0.09wt%(900ppm)以下、塩素(Cl)+臭素(Br):0.15wt%(1500ppm)以下
上記データは当社測定による代表値であり、保証値ではありません。