3つのコア技術をベースに、
お客様に最適ソリューションをご提案
お客様の製品開発スピードに大きく関わるのが、封止材の性能です。私たちは材料設計技術・プロセス技術・評価解析技術の3 つのコア技術をベースに、お客様の課題やご要望に対応します。
これまで様々な製品に採用されており、高い信頼を得ています。
材料設計技術
複数の樹脂材料の組み合わせから最適な配合、混錬、分散を見出す当社独自の設計技術を持っています。

樹脂
封止材料の構成上で基本的な特性を決め る。
接着構造
配合樹脂を異材料間で接着させる表面状 態を設計し、接着強度を制御。
樹脂構造
様々な構造の樹脂を最適に配合し結合形 状を制御。 耐熱性、耐湿性、強度等を改善。
フィラー
充填材。樹脂に一定量添加し機能の付加、 加工性の改善が可能。プロセス技術
高い封止性能を最大限に発揮させる最適な封止プロセスをご提案。
パナソニックは独自のノウハウをもとに、最適なプロセス条件や材料を的確にご提案します。さらに、お客様の製品開発スピードを高
める為、プロセス・評価設備を取り揃えたLEXCM LAB を工場内に設置。試作からプロセス評価まで短時間で実施可能です。

粉状封止材(タブレット)
粉状の封止樹脂をペレット状に固めたも の。
粉状封止材(グラニュール)
粉状の封止樹脂を顆粒状にしたもの。
液状封止材
封止樹脂を液状にして加工したもの。シ リンジに入れて供給。
シート状封止材
封止樹脂をシート状に加工したもの。加 工にラミネータが必要。評価解析技術
試作品の特性を様々な評価設備を駆使し各種プロセスで解析することで、よりお客様の要求に近い樹脂材料を提供します。

金型直圧成形装置
PoP(Package on Package)など高寸法 精度が要求される半導体パッケージ に最適。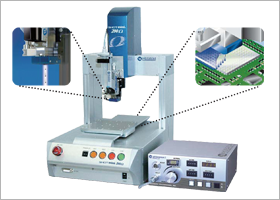
各種ディスペンサー
COB(Chip on Board)、モジュールなど 各種封止形状に対応。
超音波映像装置
超音波により内部ボイド、クラック、剥離を非破壊で分析
X線リフローシミュレーター
ボンディングワイヤの接続状態や SMD 混載モジュールの内部半田の状態 を確認。LEXCM LAB