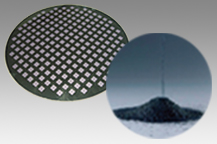
- 根據封裝厚度和整體封裝尺寸、有顆粒的各種類型產品,能夠應用於壓縮成型
- 支援大尺寸的薄型封裝體、低翹曲度要求,有助於提高先進半導體封裝的生產效率
半導體封裝材料
- 型 號

CV8511C (EMC)
- 用 途
- 詳細用途


・半導體封裝
・行動裝置
・行動裝置
用於智慧型手機、穿戴式裝置內的先進半導體封裝材料、類似WLP、PLP模壓成型及半導體晶圓背面塗層
Topics
- 2018-08-29Panasonic將FOWLP/PLP對應的顆粒狀半導體封裝材料付諸產品化
特點
低應力
低收縮率
低溫固化
FOWLP技術趨勢
Contribute to low warpage and thinner product

產品陣容和相應的半導體封裝
We have wide range of Encapsulation Line-up for WLP/PLP
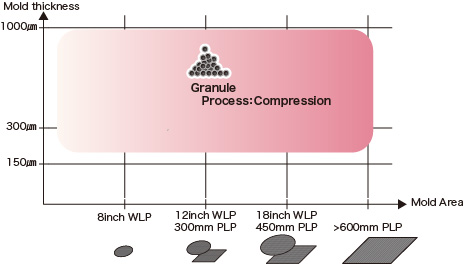
封裝方式
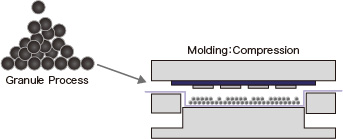
常規參數
| 項目 | 單位 | LEXCM CF CV8511CUB |
LEXCM CF X85U-PT1-AP |
| Mold Size | – |
晶圓級 / 板級
|
|
| 成型 | – |
壓縮成型 |
|
| 製程 | – |
Chip First/Chip Last |
|
| 供應形狀 | – |
顆粒
|
|
| 成型收縮率 | % | 0.15 | 0.07 |
| Tg | °C | 210 | 174 |
| C.T.E.1 | ppm/°C | 8 | 7 |
| C.T.E.2 | ppm/°C | 56 | 25 |
| 彎曲彈性率 (25°C) | GPa | 8 | 30 |
The above data are typical values and not guaranteed values.

