
- 極薄材料により、半導体パッケージの薄型化や、熱膨張が低いためサブストレートの低反りを実現
半導体デバイス材料
- 品 番

- 用 途
- 詳細用途

・半導体パッケージ基板
CSP (DRAM, NAND/PMIC, Mini LED など)
FC-CSP (APU, RF-IC など)
FC-CSP (APU, RF-IC など)
新規品番
Laminate R-151YE
Prepreg R-141YE
既存品番
Laminate R-1515E
Prepreg R-1410E
- 既存品番と新規品番にて、一部、UL認証項目の内容について差異がある場合がございます。
詳細は担当営業もしくはこちらのフォームからお問い合わせください。
品番末尾の()カッコ内の文字は当社における識別区分であり、UL認証の登録をしている品番には含まれておりません。


主要特性
曲げ弾性率
25°C 33GPa
25°C 33GPa
CTE x, y-axis
9ppm/°C
9ppm/°C
Tg (DMA)
270°C
270°C
パッケージ基板反り評価結果(FBGA)
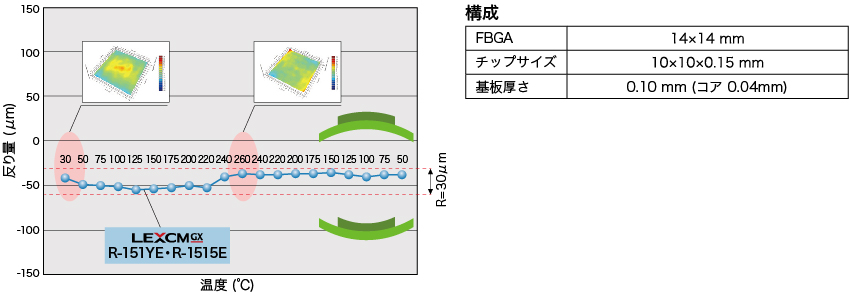
熱膨張量(タテ方向)

一般特性
| 項目 | 試験方法 | 条件 | 単位 | LEXCM GX R-151YE R-1515E | |
| ガラス転移温度(Tg) | DMA※2 | A | °C | 270 | |
| 熱分解温度(Td) | TGA | A | °C | 390 | |
| 熱膨張係数(タテ方向) | α1 | 社内法 | A | ppm/°C | 9 |
| 熱膨張係数(ヨコ方向) | 9 | ||||
| 熱膨張係数(厚さ方向) | α1 | IPC-TM-650 2.4.24 | A | 22※1 | |
| α2 | 95※1 | ||||
| 曲げ弾性率 | JIS C 6481 | 25°C | GPa | 33※1 | |
| 250°C | 18※1 | ||||
試験片の厚さは0.1mmです。
※1 0.8mm
※2 引張りモードでの測定
当社のハロゲンフリー材料は、JPCA-ES-01-2003などの定義に拠るものです。
含有率が塩素(Cl):0.09wt%(900ppm)以下、臭素(Br):0.09wt%(900ppm)以下、塩素(Cl)+臭素(Br):0.15wt%(1500ppm)以下
上記データは当社測定による代表値であり、保証値ではありません。

